LayerProbeとOmniProbe 400を使用した高品質なTEMラメラ作成とオンチップ分析
TEMラメラの局所的な厚さと組成を測定できる新しい技術を紹介し、半導体デバイスの故障解析への応用について議論します。
デバイスの歩留まり、性能、または信頼性に影響を与える故障の根本原因を理解することは、半導体製造プロセスにとって非常に重要です。デバイスの微細化や形状の複雑化に伴い、微細な電気的欠陥を見つけ出し、デバイス全体から切り離すことが難しくなってきています。
半導体の故障解析における大きな課題の一つは、実際に故障したデバイスを見つけることです。光ビーム誘起抵抗変化(OBIRCH)のような光学技術で必要な分析領域は、単一デバイスの分解能はありません。SEMでも、故障部位は埋もれた層の中にあるため、実際には見えないことがあります。このようなナノメートルスケールのデバイスでは、電子ビーム誘起電流(EBIC)および電子ビーム吸収電流(EBAC)イメージングにより、表面下の構造であってもデバイスの電気応答の可視化とマッピングが可能になります。 OmniProbe200と400は、再現性の高いナノスケールの位置決めを実現しているため、デバイスの最小の特徴を電気的に接触させることができます。これにより、電流を発生させるICデバイスの電気的テストが可能になります。

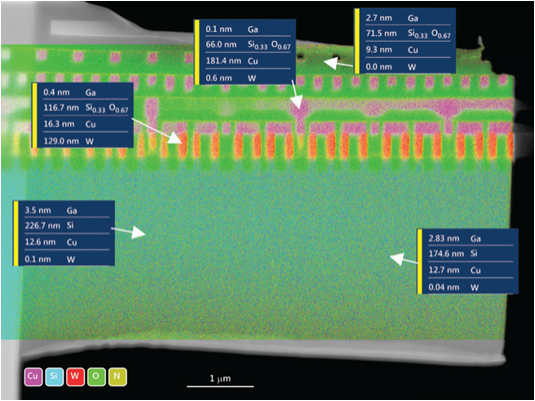
一旦故障したデバイスを発見したら、通常、さらなる物理的な分析のために、そのデバイスを分離または除去する必要があります。これは通常、埋設されたデバイスにアクセスし、TEMを使用した高分解能の調査を可能にするためのリフトアウトプロセスによって達成されます。デバイスが小さくなるにつれ、リフトアウトはそのデバイスの長さのスケールで行うことが難しくなり、処理されたウェーハの残りの部分への影響を減らすために、より特定の部位に特化したものでなければなりません。 これらの課題は、故障解析業界の厳しいスループット要件を満たしながらも克服しなければなりません。OP400はこれらの課題の多くを解決します。ピエゾ駆動のモーションにより、25nmの位置決め精度を実現し、小さな領域でもサイトを特定することができます。また、この小さなステップサイズは、電子イメージ内での流体の動きを意味し、ユーザーは繰り返し精度を保ちながら迅速にプローブを位置決めすることができるため、リフトアウト時間を短縮することができます。また、チップがクラッシュした場合のダウンタイムを短縮するin-situチップ交換により、生産性がさらに向上します。
最後に、OP400では回転を標準装備しているため、Back-side-thinningなどの高度な試料作製技術が可能です。このような技術により、試料中のカーテンの影響を減らすことができるため、最終的にTEMに試料が到達したときに、より高い分解能での分析が可能になります。最適化されたラメラ前処理を確実に行うために、OmniProbeはEDSやAZtec LayerProbeと併用して、試料の厚さや製造イオンビームによるコンタミネーションに関するフィードバックを提供することができます。
半導体、電子機器、記憶装置に戻るTEMラメラの局所的な厚さと組成を測定できる新しい技術を紹介し、半導体デバイスの故障解析への応用について議論します。