LayerProbe
LayerProbeの特徴、利点、動作原理、そしてその応用例を紹介しています。(英文カタログ)

LayerProbe は SEM での薄膜分析のための刺激的なソフトウェアツールです。AZtec EDS マイクロアナリシスシステムのオプションである LayerProbe は、薄膜測定専用のツールよりも高速で、より費用対効果が高く、高分解能です。
SEM での薄膜分析
試料表面下の複数の層の特性評価が可能
非破壊分析
2 nm から 2000 nm までの複数の層の厚さと組成の分析が可能
200 nm までの横方向分解能
定常的利用者向けの設定が簡単で、SEM または FIB-SEM の機能拡張として高い費用対効果
AZtecEnergy への拡張: シームレスに統合することができ、既存の装置に容易に組み込むことが可能
LayerProbe は、試料の表層と表面下層の組成と厚さを分析、測定することができます。確立されたマイクロアナリシス技術に基づく非破壊的なツールであり、薄膜測定専用ツールよりも費用対効果が高く、高分解能でより高精度です。
LayerProbe は、表面下の個別の層の組成と厚さも計算することにより、従来の EDS 分析から得られる元素と相の情報を補完します。
TEMラメラの局所的な厚さと組成を測定できる新しい技術を紹介し、半導体デバイスの故障解析への応用について議論する。(英文アプリケーションノート)
太陽光発電(PV)セルは、低炭素の再生可能エネルギーを生成するための魅力的なオプションですが、従来の設計では、望ましくない有毒化合物を含むことが多く、特別な条件の下で製造しなければなりません。(英文アプリケーションノート)
LayerProbe は、半導体製造の前工程および後工程、半導体の研究開発、光学用・工業用コーティング、ナノ電子デバイスなど、幅広い用途に最適です。
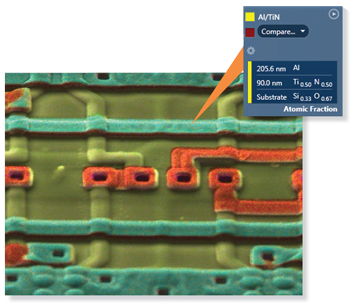
LayerProbeは、TEMラメラの厚さと品質をその場で定量化する新しい方法を提供します。また、FIB-SEMを使用した層状試料の断面分析に補完的な技術としても利用されています。

LayerProbeは実証済みの技術に基づいており、他の技術と比較して大きなメリットがあります。
LayerProbeと他の技術との比較
| LayerProbe | エリプソメトリ | FIB/TEM | RBS | |
| 非破壊 | 〇 | 〇 | X | 〇 |
| 高い空間分解能 | 〇 | X (>>1 ミクロン) | 〇 | 〇 |
| 高速分析 | 〇 (各ポイントを数秒で計測) | 〇 | X (数時間) | X |
| 価格 | 相対的に安価 | 高価 | 非常に高価 | 非常に高価 |
LayerProbeの正確性は?
シリコン基板上ALD膜の比較
| LayerProbe 膜厚 (nm) | 密度 (gcm-3) | エリプソメトリ 膜厚 (nm) | 屈折率 | |
| HfO2 | 28.1 ± 0.1 | 9.4 | 33.6 ± 5 | 2.04 |
| Al2O3 | 57.0 ± 0.2 | 3.0 | 52.8 ± 5 | 1.64 |
LayerProbe EDSとRBSDの組成比較
| LayerProbe - ストイキオメトリック比 | RBS - ストイキオメトリック比 | |
| Hf /O | 2.13 | 2.07 |
| Al /O | 1.56 | 1.60 |
分析例: PCB - Si基板上のAu/Ni層
LayerProbeとXRFの膜厚計測比較
| LayerProbe 膜厚 (nm) | 密度 (gcm-3) | XRF 膜厚 (nm) | |
| AU | 60.1 ± 0.7 | 19.3 | 61 ± 25 |
| Ni | 123.5 ± 0.7 | 8.9 | 141 ± 24 |
SEMの断面観察で結果を検証...