28th July 2021 | Author: Dr John Lindsay
FIB-SEMは、SEMとTEMの両方の分析を行うための、比較的一般的な試料作成方法です。 イオンビームで試料を作成する場合、良い試料を作るためには様々な点を考慮する必要があります。良好なサンプルとは、イメージが良好なもの(サンプル調製による明らかなアーティファクトがないもの)と考えられがちですが、分析に関してはそれだけではありません。ここでは、FIBの試料調製が分析に与える影響の例をいくつか挙げ、その影響を軽減するためのアドバイスをご紹介します。
カーテニング
FIBで試料を作成する際、最も顕著に現れるのがカーテニングです。 試料に異なる材料が含まれて、ミリングレートが異なると、カーテニングが発生することがあります。この現象は、イメージング・アーティファクトの原因となり、またTEMサンプルを作成する際に許容されるサンプルの厚さが制限されるため、望ましくないとされています。分析の際には、カーテニングに伴う凹凸がシャドーイングや低エネルギーピークの吸収の原因となります。
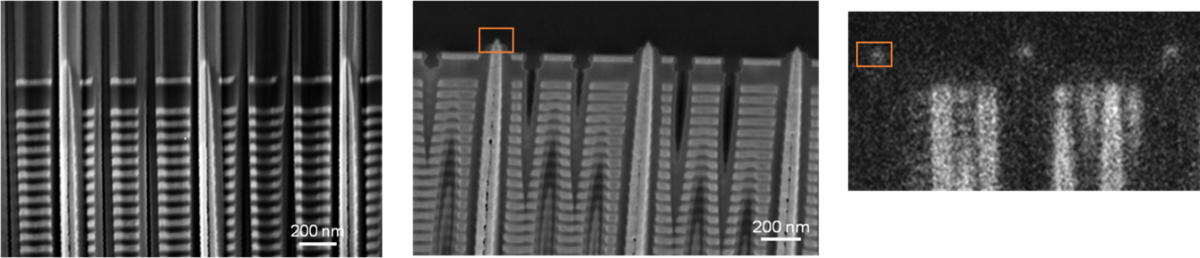
図. 1 左: カーテイングを伴う通常のミリングで調製したサンプル; 中央: カーテニングを防ぐために裏面から薄膜化したサンプル調整; 右: 裏面から薄膜化したサンプルの窒素EDSマップ。
上の例では、同じサンプルの分析領域でカーテニングの有り無しでサンプルを調整したものです。 (その詳細はこちらをご覧ください。) Ultim Extremeを用いたEDSマッピングでは、タングステンバイアスの先端部(オレンジ色の枠で示した部分)に窒素が集中していました。 カーテニング有のサンプルで同じ分析を行ったところ、この窒素濃度は観測されませんでした。 カーテニングを緩和するための一般的な方法としては、試料の向きを変える、保護層を蒸着する、イオンビームの電流を下げてミリングする、などがあります。
コンタミネーション
またイオンミリングによるEDS分析への影響として、コンタミネーションが考えられます。 コンタミネーションは、ミリングに使用したイオンが注入されたり、ミリングされた材料がサンプルに再付着したりすることで発生します。 再付着は通常、(限定されませんが)断面の底部で観察されます。再付着した材料の組成は、ミリングされた材料(サンプルまたはリフトアウトグリッドなどの支持構造物から)とイオンビームからのイオンの組み合わせです。 下の例(図2)は、固体リチウムイオン電池(ガリウムを含まない)にガリウムが混入したものです。 断面のEDSマップでは、断面の下部にかなりの量のガリウムが観察されますが、分析対象の粒子の上部には見られないことが重要です。

図. 2 リチウムイオン電池の断面図。断面の下部に再付着が見られます。これは(材料中には含まれない)ガリウムのEDSマップで確認できます。
過剰なミリングを避け(分析対象となる表面より下の材料をミリングしないように)、準備の最終段階ではダメージの低い条件を使用することで、再付着を最小限に抑えることができます。他に注意すべきこととしては、銅を含むサンプルを分析する場合、銅製のリフトアウト・グリッドは避けるべきです。
構造の変化
イオンミリングによって影響を受けるのは、サンプルの化学的性質だけではなく、結晶構造にも影響を与えることがあります。 よく知られている例では、シリコンのアモルファス化があります。 図3のEBSD信号画像は、同じシリコン結晶から収集したものですが、一方は30keV、500pAで研磨した後に撮影したもので(キクチパターンは発生していません)、もう一方は5keV、500pAで収集したものです。(菊池パターンははっきりしています。) パターンが得られていないのは、検出器のせいではなく、EBSDが表面に敏感な技術であり、表面がアモルファス化しているためにパターンが発生しないためです。

図. 3 シリコン単結晶から得られたパターン。左は30keV 500pAのイオン研磨後、右は5keV 500pAのイオン研磨後。いずれも20keV、1nAの電子ビームで取得した同じマップから抽出したもの。
相変態
イオンビームの相互作用は、結晶構造を破壊するだけでなく、相を変化させることもあります。 その代表例がオーステナイト系ステンレス鋼(SS)です。 下の図(Fig.4)は、異なるイオンビーム量にさらされた3つの領域を持つオーステナイト系SSのEBSDマップです。 異なる照射量は、垂直にイオンビームを30秒、20秒、10秒と照射することで準備しました。(30keV、1nAのビーム、300nSのデュエルタイムを使用)高照射量の領域ではオーステナイトからフェライトへの相変態が起きていますが、低照射量の領域では相変態は起きていません。
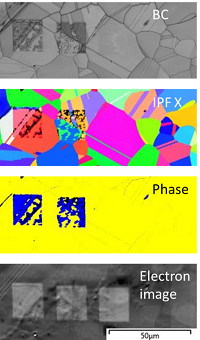
図. 4 バンドコントラスト、方位、結晶相マップ(オーステナイトを黄色、フェライトを青)と対応する電子線画像。3つの領域に30keV、1nAのイオンビームを照射した。イオンビームの照射時間は左から右に向かって短くなっています。
結晶学的ダメージを避けるためには、イオンビームの加速電圧が鍵となり、低電圧ではダメージが発生しにくくなります。しかし上記のSSの例が示すように、照射量も重要な要素となります。
イオンビームがサンプルにダメージを与える例を紹介しましたが、これらの影響は稀であり、多くの場合、注意して回避/軽減することができます。 新しい材料やイオン源(ここではすべてGa FIBの例を示しています)を使用する際には、それらの相互作用を理解することが重要です。 EBSDとEDSを使用することで、生成されたサンプルの特性に加えて、相互作用を定量化することができます。