ナノマニピュレーターの電気的接続が望ましい理由はたくさんあります。ここでは、EBICやEBACのような様々な高精度の電気的検査方法だけでなく、電気的に接続されたプローブがFIB-SEMのイメージング能力を向上させるためにどのように使用できるかを紹介します。
電子顕微鏡の試料は常に電気回路の一部であり、電子ビームから供給された電流は接地された試料ステージを通って散逸します。真空中の絶縁体試料などで電気回路が破壊されると、電子ビームからの電子が試料を帯電させます。 試料に電荷が蓄積されると、電子ビームと相互作用し、高品質の画像を得ることができなくなります。これは通常、試料に導電性コーティングを施したり、試料の周囲に存在するイオン化ガス原子が電荷を散逸させる低真空下で作業することで解消されます。 しかし、コーティングも低真空モードも、FIB-SEMでの作業には理想的ではありません。なぜなら、コーティングは少なくとも試料のイオンミリングによって局所的に除去されることが多く、高品質の成膜とイオンビームによるミリングには高真空が必要だからです。このような状況下では、電気的に接続された接地されたプローブを、画像化する領域の近くに設置し、電子ビームによって誘起された電荷をプローブを通して放出して、電荷の蓄積を中和することができます。
これにより、荷電が電子ビームの到達エネルギーに影響を与える分析結果が改善され、より定量的なEDSが得られるようになります。またこの方法は、GIS堆積およびイメージングの品質を向上させるために使用することができます。 この良い例としては、コーティングされていない岩石サンプルが挙げられますが、ガラス、電気デバイス、生物学的サンプルなど、他の多くのサンプルにも使用できます。

コーティングされていない地質試料をOmniProbeで帯電させ、局所的に接地させた状態で画像化。
現在のすべてのオムニプローブには、プローブ先端への電気的接続だけでなく、コントローラに内蔵された±10V電源も含まれています。 これにより接触検出と電圧コントラストイメージングという2つの重要な機能が可能になります。
プローブとサンプルの接触検出: 前述のように、サンプルは通常、充電を避けるためにステージに電気的に接続されています。 プローブ先端にバイアスをかけて電圧を測定した場合、電圧の急激な低下は、プローブが導電性サンプルに接触したと解釈できます。 この信号を設定することで、プローブの動きを無効にすることができます。顕微鏡ステージタッチアラームを作動させないためには、プローブ先端の電圧をステージバイアスに合わせて設定することが重要です。

電気的接触の警告と、警告を上書きするオプションを示すOmniProbeソフトウェアの画像。
サンプルの電気的特性をイメージング
電気デバイスの欠陥を明らかにするために、あるいは電子材料内の欠陥を明らかにするために、電気的に強調されたイメージングが望ましい場合があります。 OmniProbeを使用してこれを行う方法の1つは、プローブ先端を介してサンプルに電圧を印加し、電圧コントラストイメージングを行うことです。画像のコントラストは、プローブに対する異なるサンプル領域の電気的接続性に依存するため、ナノスケールの電子回路の断線や接続不良を明らかにするために使用することができます。 以下の例(J Mater Sci: Mater Electron (2011) 22:1523-1535)は、故障の識別を示しており、その後のFIB断面検査では開回路であることが示されています。
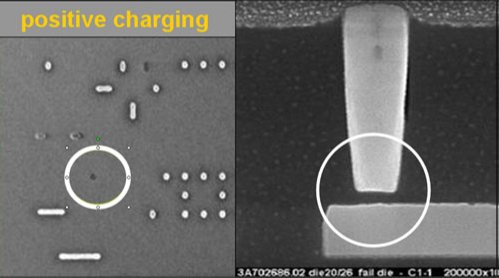
電圧コントラスト画像は開回路の位置を示しており、FIB断面でこれを確認しています。
電子機器のより高度な特性評価では、パラメトリックアナライザーやソース測定ユニット(SMU)を使用します。それぞれのプロセスは、うわべを撫でるのに数回のブログが必要となるため、ここではこれらの詳細については触れません。アナライザーの重要なポイントは、設定した電圧と電流を印加しながら、デバイスの特性を評価するために応答を測定することができることです(電圧を印加して電流を測定する従来の測定とは対照的に、またはその逆)。電流発生型半導体デバイスの場合、測定される信号はピコアンペア単位であることが多いです。良好な信号を確保するためには、電気接続を低ノイズの電気テストオプションにアップグレードする必要があります。これは、プローブ制御電子機器から分離されており、OmniProbe本体の専用接続を使用して信号ノイズを最小限に抑えます。テストには、複数のプローブを使用することがよくあります。
電子線試験法には、大きく分けて電子線誘起電流(EBIC)と電子線吸収電流(EBAC)の2種類があります。他の方法もありますが、それほど広く使われているわけではありません。いずれも試料中の電子ビームで発生した電流(通常は高帯域のピコアンメータとスキャンジェネレーターを用いて)を測定し、その結果を電流マップとして出力します。EBICとEBACの主な違いは、試料中で発生する物理的相互作用です。EBICの信号は通常、EBACよりも数桁大きくなります。
EBICは、電子ビームがP-N接合(半導体)と相互作用して電流を誘起することで発生します。この解析は、半導体の製造や太陽電池などの構造物の研究によく使われています。この方法は、可視化と定量化の両方に有効です。下の例は、マイクロチップのP-N接合を示しています。低ゲインで誘導電流を定量化することができ、抽出されたラインスキャンから電流分布をより詳細に見ることができます。誘導電流の分布は、多くの場合、局所化学や結晶学などの他の材料特性とリンクしています。より高いゲインでは、P-N接合信号が増幅器を飽和させ、EBAC信号が可視化されます。低ゲイン画像ではEBIC信号によって矮小化されているため、この信号は実行可能ではありません。
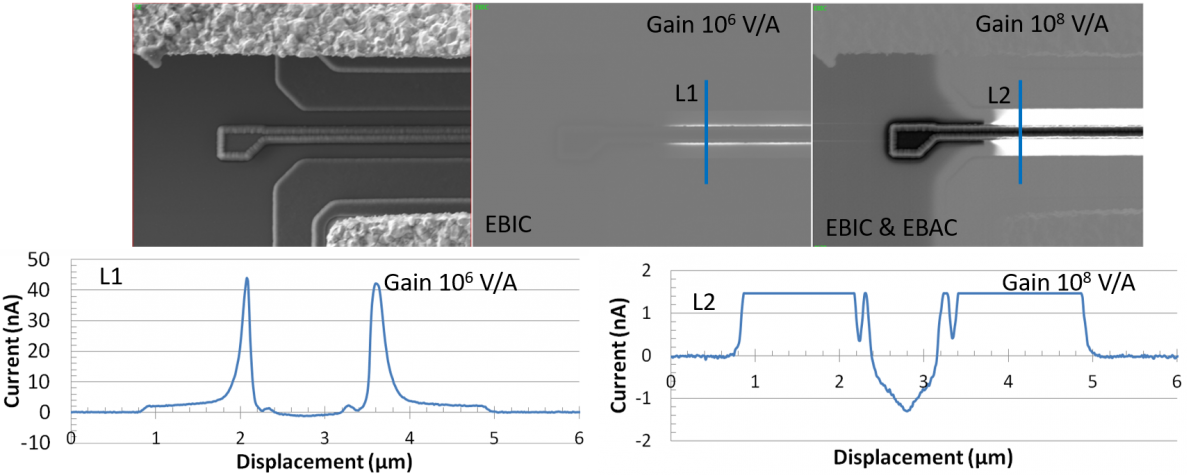
マイクロチップのP-N接合。 低ゲイン画像は接合の特性を示し、高ゲイン画像はチップ内の接続の可視化します。
EBACは、電子ビームからの電子がサンプルに吸収されてプローブに流れる様子を測定するものです。一般的な用途は、短絡や開回路などの回路の故障を検出することです。下の例ではクラックが入ったマイクロチップを示していますが、クラックが入ったところでEBAC信号が消失していることが明らかになっています。故障は明らかですが、この方法は画像では見えない埋もれた故障を解析するために使用できます。これは上記のEBICの例と同じマイクロチップですが、加速電圧が低下しているため、P-N接合が活性化されていないことは注目に値します。

マイクロチップのEBACイメージ。 クラックがプローブへの電流の流れを妨げていることは明らかです。オレンジ色のボックスは、前のEBIC画像で画像化された領域を示しています。
EBICとEBACはどちらも試料からプローブに流れる電子を測定しますが、結果的には試料上のプローブの正確な接触点に依存します。より複雑なアプリケーションでは、複数のプローブを使用して設定点に対する相対的な流量を測定したり、サンプルにバイアスをかけて特定のデバイスを作動させて流量を変化させたりします。
この簡単な紹介で、電子顕微鏡でどのような電気的検査ができるのか、ご理解いただけると思います。OmniProbeによる電気的検査の詳細については、アプリケーションノートをご覧ください。: mc-Si太陽電池の性能向上のための転位と粒界のマルチスケール解析